灌封(Potting / Encapsulation)是一种通过将整个 PCB 或电子组件嵌入到固化树脂块中,从而实现全面保护的工艺。灌封可提供极高等级的防护:厚实的高分子外壳能够有效隔绝湿气、腐蚀性介质和灰尘,并显著提升机械强度。因此,该工艺被广泛应用于工业电子设备或需要在恶劣环境下运行的应用场景。
在灌封过程中,已完成装配的电路板会被放置在容器或模具中(即“灌封槽”),随后将液态灌封材料(通常为环氧树脂、聚氨酯或硅胶)倒入或点胶覆盖其上,使其完全填充所有空隙并包覆电子元件。随后材料发生固化,形成一个整体的固态结构,将电子组件完全封装其中。
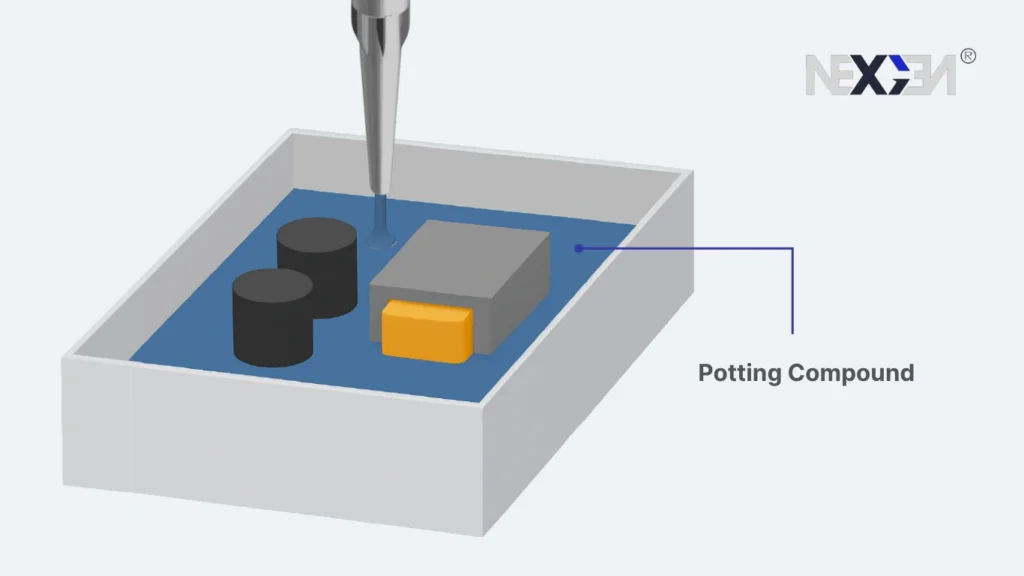
从点胶与供料的角度来看,灌封材料对设备和工艺提出了多方面的挑战与要求:
- 双组分混合:大多数灌封材料为双组分体系,必须在点胶过程中按照精确比例进行混合。然而,材料在混合后只有有限的可操作时间(Pot Life),随后便会开始固化。设备必须在该时间窗口内完成灌封填充。包括双组分输送、精确定量、充分混合以及稳定点胶在内的所有步骤,都需要在可控且可靠的条件下完成,才能满足灌封质量要求。
- 高粘度与流量控制:
灌封树脂的粘度范围从较低到非常高不等。高粘度材料在大体积灌封时会延长填充时间,因此点胶系统必须保持连续、稳定的流动,避免断续或喷溅。同时,启停流量的控制也十分关键——高粘度树脂在阀门关闭后容易拉丝。为此,点胶阀通常需要具备回吸(Snuff-back / Suck-back)功能,以实现干净利落的断胶。 - 气泡与空洞:
在混合或点胶过程中产生的气泡,可能会被困在元器件周围。灌封固化后,这些空洞不仅会削弱机械防护性能,还可能导致湿气渗入或形成局部过热点。然而,避免气泡并不容易,因为双组分混合本身就可能引入空气,而复杂的器件结构也容易形成空气滞留区。 - 污染与溢料:
大体积树脂点胶容易造成污染。如果点胶路径或出胶量控制不当,材料可能溢出模具或流入不应覆盖的区域。系统必须具备平稳、可控的大流量点胶能力。此外,已固化的树脂极难清除,因此精准地将材料点胶到目标区域至关重要。

NEXGEN CMI 提供集成式计量-混合-点胶系统及完整的工艺解决方案,专门应对灌封应用中的各类挑战。制造商可以放心地对 PCBA 进行灌封,确保每一件产品都按正确比例混合、无气泡缺陷,从而获得耐用可靠、符合最高防护标准的最终产品。欢迎联系我们的专家,咨询灌封解决方案。
灌封系统咨询